
nanoHUB.org - Resources: ME 290R Lecture 2.1: Lithography Performance Criteria - Technical: Watch Presentation
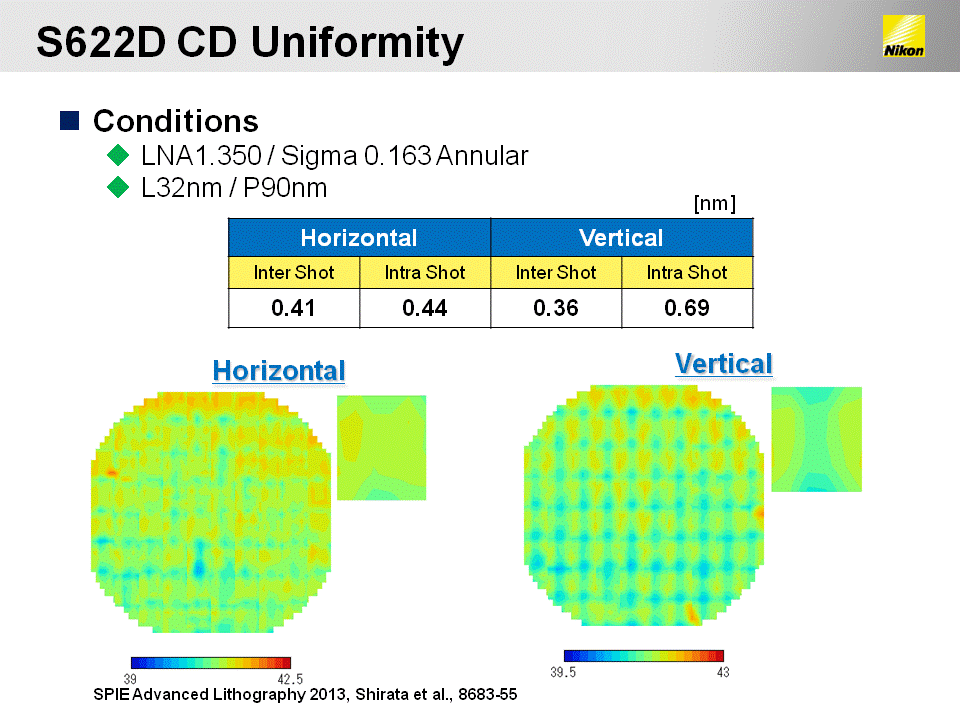
Intel and Nikon Litho Specialists Discuss Overlay Matching and Edge Placement Error for Production Beyond 20 nm

CD uniformity at pitch 80nm after a/litho and b/etch for negative tone... | Download Scientific Diagram
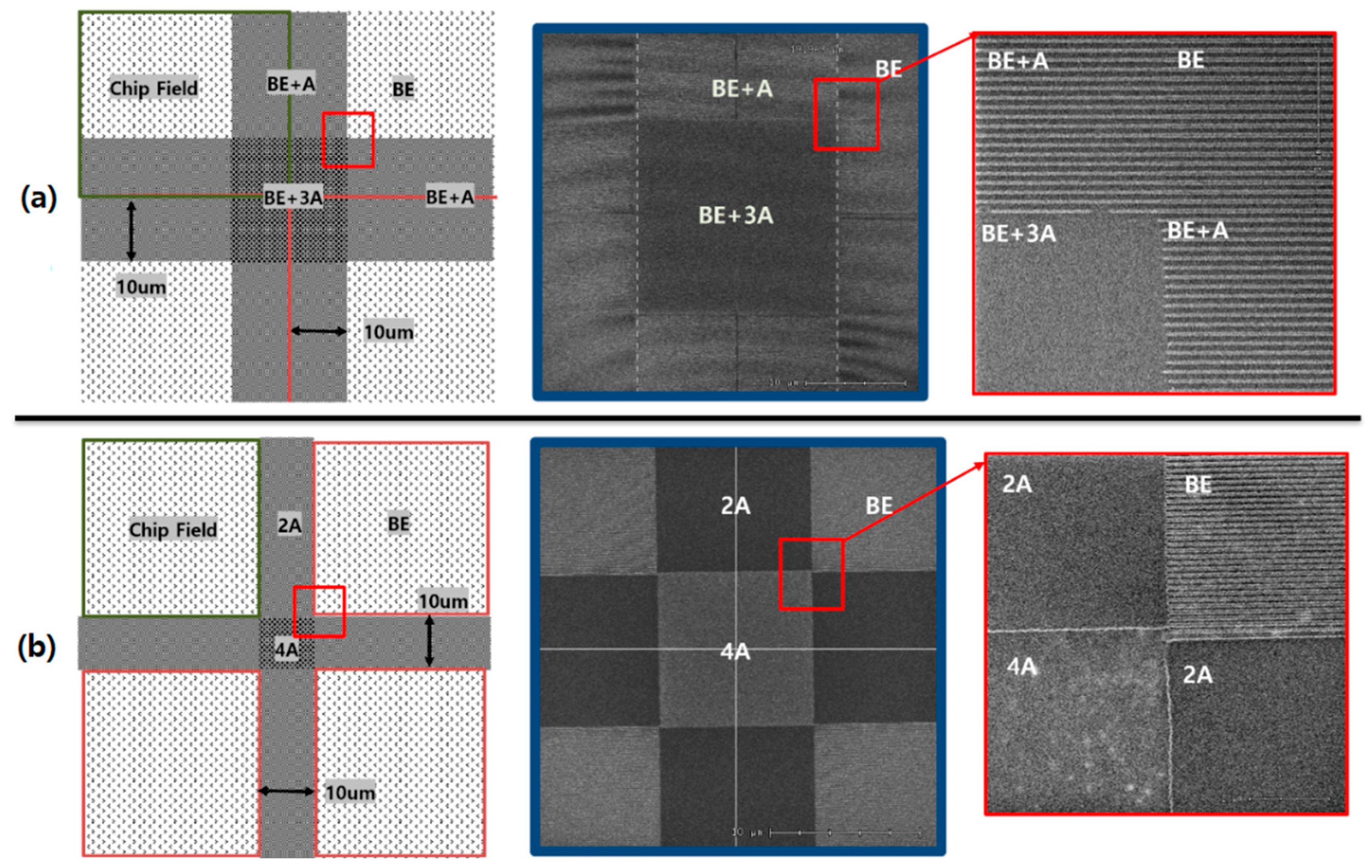
Nanomaterials | Free Full-Text | 300 mm Large Area Wire Grid Polarizers with 50 nm Half-Pitch by ArF Immersion Lithography
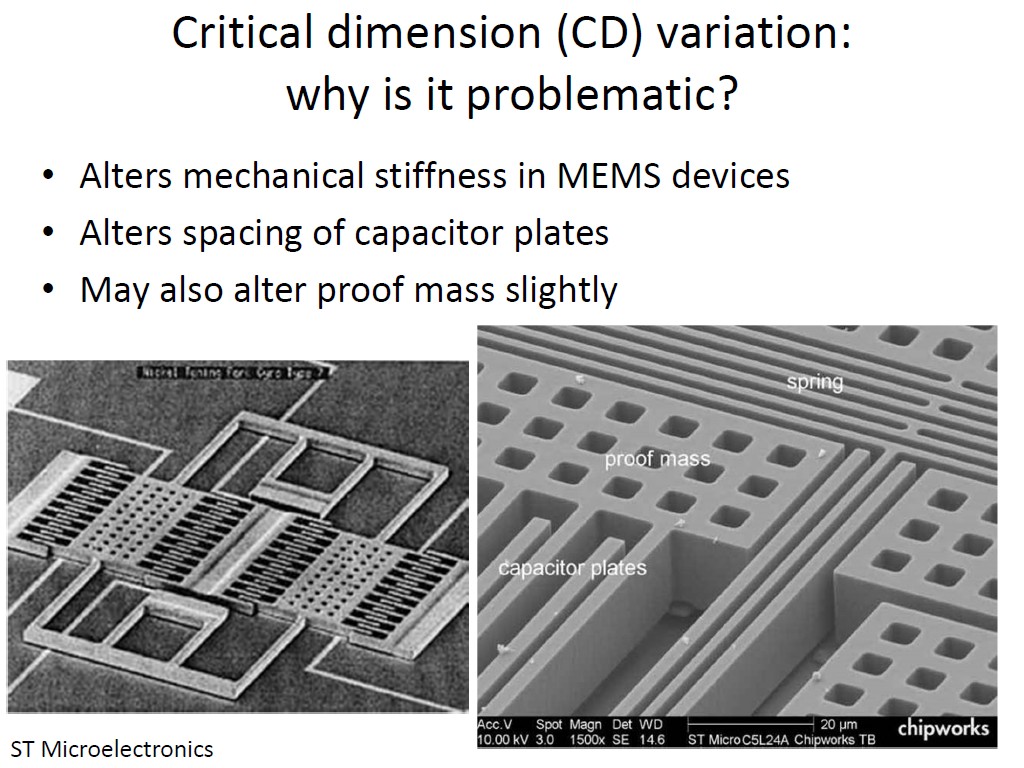


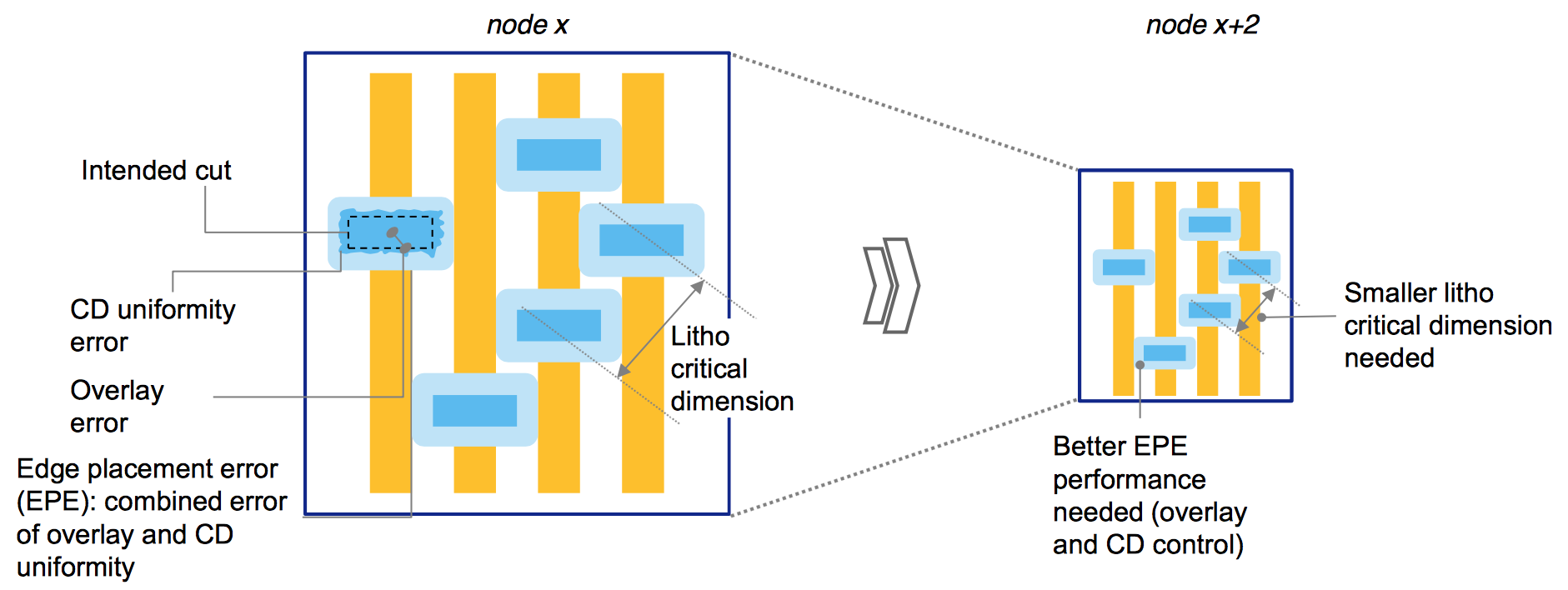
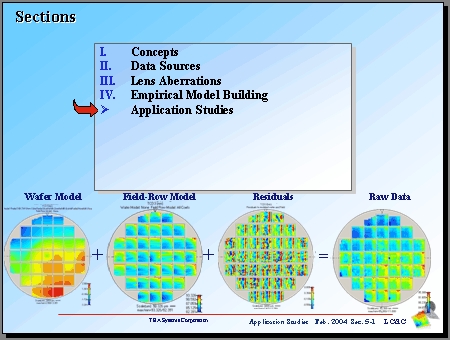




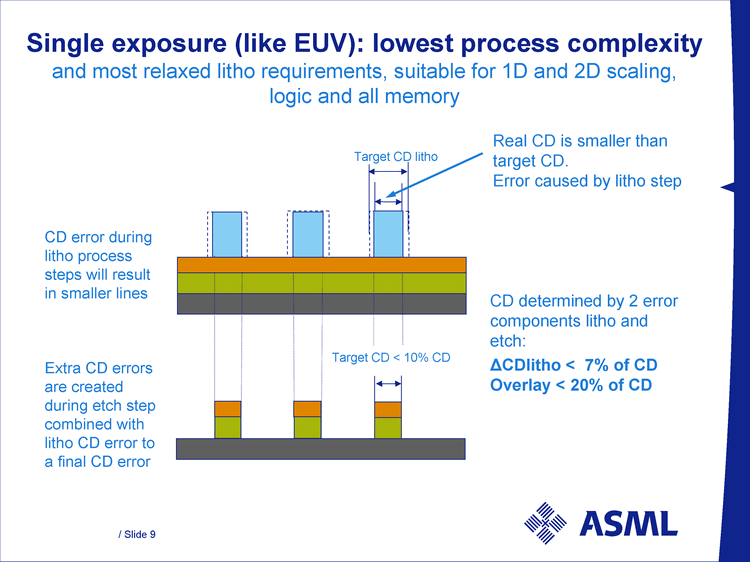
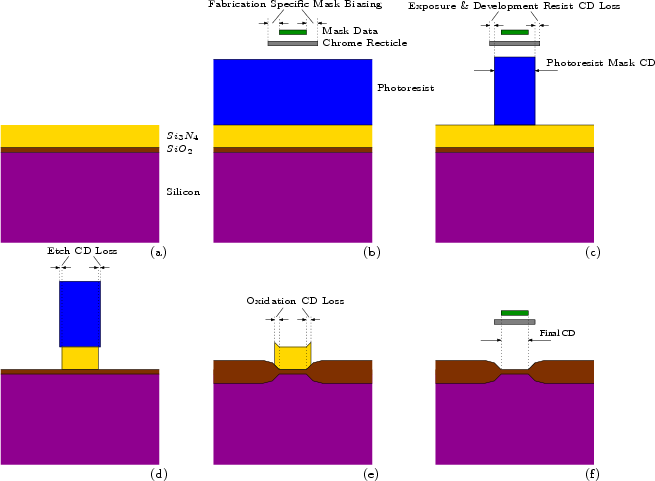
![Photolithography Par4] CD Measurement & Control - YouTube Photolithography Par4] CD Measurement & Control - YouTube](https://i.ytimg.com/vi/7L1S63B0XpI/maxresdefault.jpg)